
蛍光X線分析装置 SEA1200VX 株式会社日立ハイテクサイエンス社製
2) 鉛フリーフローはんだ鉛含有量の定期分析

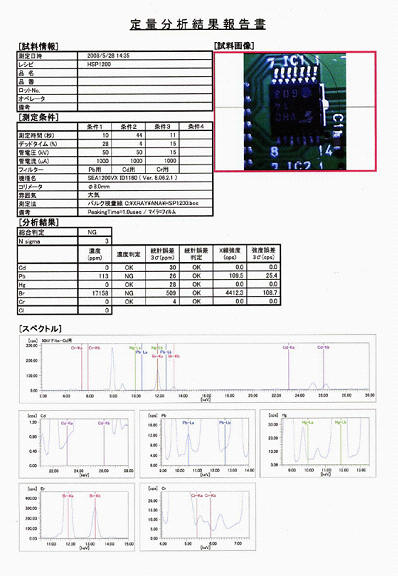
<製造技術>
1) 確かな品質維持を確実にするリワーク RoHS2も対応いたしています。
BGA・CSPの検査・交換に付きましては、リワーク装置及びマイクロフォーカスX線検査装置を導入し顧客殿の要求に対応させて頂いています。
リワーク装置はバンプピッチ0.5mm・0.65mmのBGA・CSPから50mm角サイズのBGAまでを交換可能です。


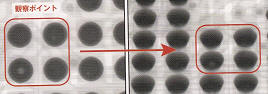

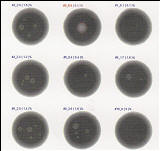

2) 高精度、高速実装が可能
表面実装ラインは最大寸法475mmX356mmの基板が可能な表面実装ラインを3ライン有し
搭載精度はBGA・CSP・QFP等の高精度を必要とする部品で±0.030mm/QFP (Cpk≧1)、
チップ部品で±0.038mm/chip (Cpk≧1)を有し0402サイズのチップも搭載可能で、
安定した高品質な実装を実現しています。もちろんRoHS2も対応いたしています。

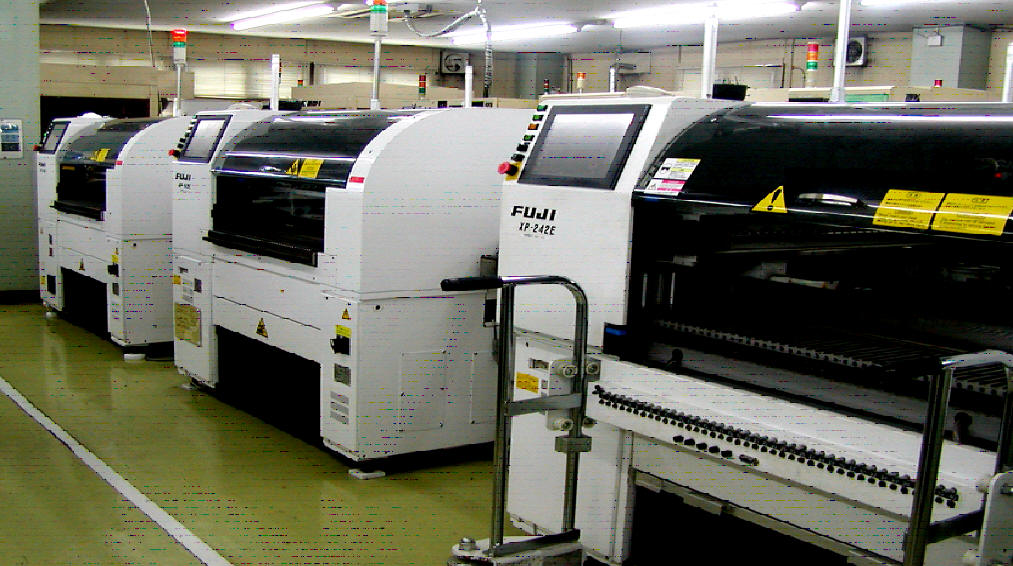

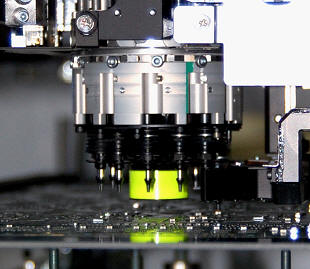


3) 確実な半田付けを可能とする印刷 ・ 高精度0.1mm間隔の狭ピッチ実装

高性能コンパクト印刷機 YCP10 (はんだ印刷検査付き)


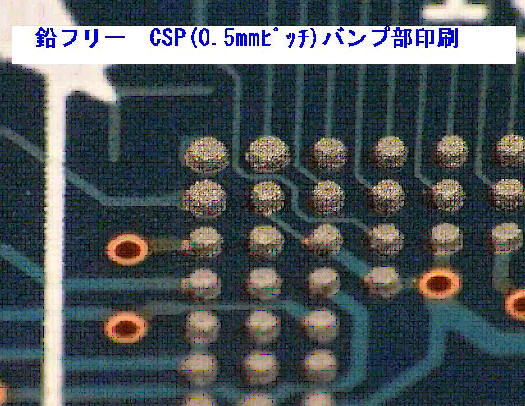
![]()
4) リード部品のRoHS2対応
リード部品のRoHS2対応半田付けのため、N2傾斜式ウエーブ ソルダリング システム
を導入し顧客殿の要求に対応させて頂いています。 基板の最大寸法は400(W)X450(L)mmです。


5) リード部品の自動半田付け装置 RoHS2・共晶対応
後付リード部品の自動半田付け対応のため、セイテック社製 セレクティブトレース半田付装置 STS-3050SJを2012年10月 に、
STS-500Plusを2020年10月に、STS-5050SJを2020年9月に、STS-450Plusを2023年8月に導入し顧客殿の要求に対応させて頂い
ています。
基板の適用サイズ(50X50〜500X300mm)です。
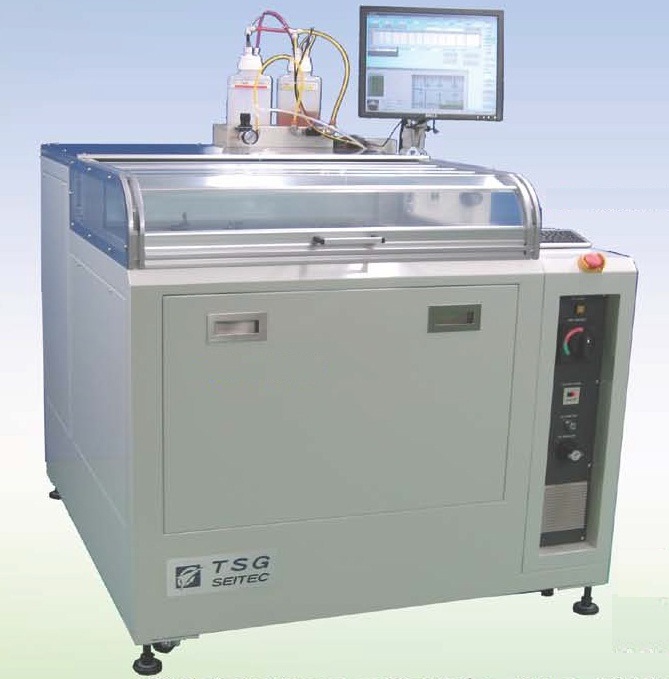
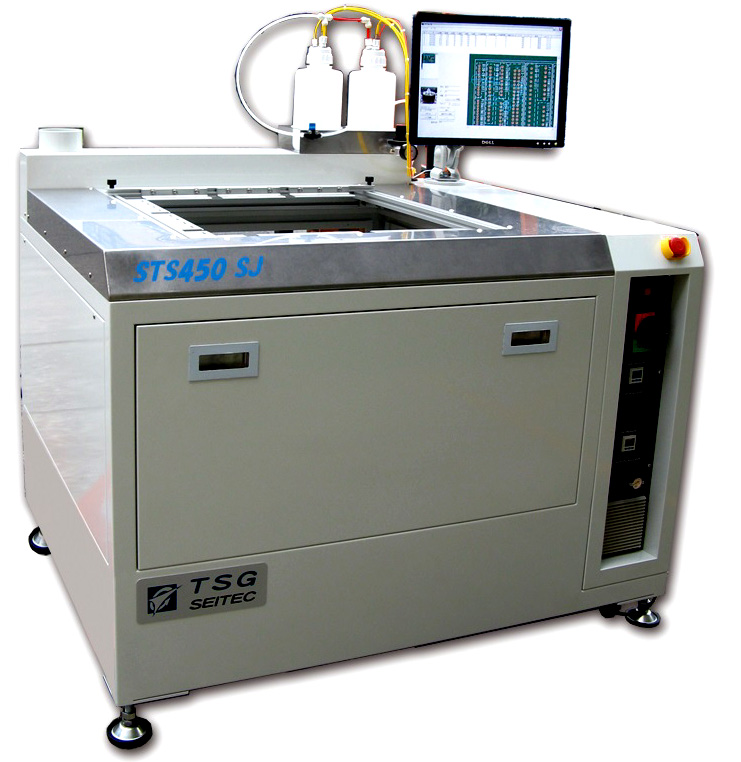
6)-1 はんだ印刷検査機 (CKD社製) 適用サイズ(50X50〜650X550mm)
三次元画像の確認により基板のはんだ印刷状態を診断し良否判定する装置です。 1台
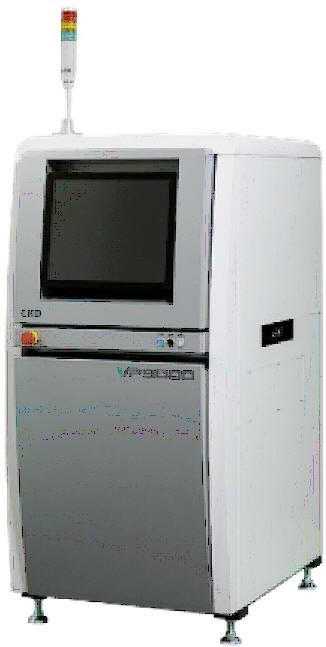


VP9000L リング照明(360度全方位) 3Dプロジェクタによる三角測量
6)-2 画像検査装置 (オムロン社製) 適用サイズ(50X50〜650X550mm)
画像の確認により部品の有り無し・極性・定数・半田付けの良否判定する装置です。 4台

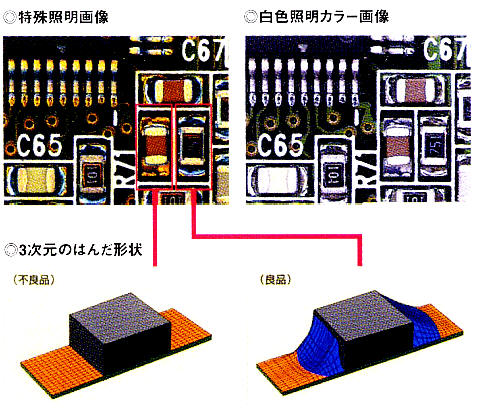
![]()
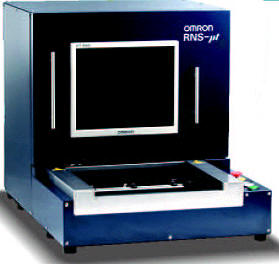

7) X-Y インサーキットテスター1240 (日置社製) 適用サイズ(50X50〜510X460mm)
インサーキットテストにより部品の有り無し・極性・定数・半田付けの良否判定する装置です。

8) カメラ搭載卓上型ルータ基板分割機(株式会社サヤカ 製)2024年12月導入予定

最大基板サイズ W 350 × 250 mm
切断可能基板厚 t=0.4−2.0mm
基板実装高さ制限 23mm(表側)
ルータビツト仕様 φ0.8−φ3.0
最大切削速度 50mm/sec
最大移動速度 500mm/sec
繰り返し精度 ±0.01mm以下
Z軸ストローク 40mm
スピンドル仕様 25,000 − 50,000 rpm (可変式)
X/Y/Z軸制御 サーボモータ
電源仕様 AC100V 50/60Hz
最大消費電力 約1.2 kVA (集塵機含む)
空気圧 エアー不要
外径寸法 W800XD700XH510mm約70 Kg
*カメラで基板」を見ながらティ−チングが可能
*画像処理機能搭載で切断位置自動補正
*QRコードにて切断プログラム自動切替標準装備
*ルータビツトの高さを自動で切替え、
長寿命化を実現
*実装後の基板を低ストレス且つ安全に切断
*量産だけでなく、試作用途にも最適
*エアーレス・AC100V動作ですので
設置場所を選びません
9) 3Dプリンター X-max 印刷サイズ300x250x300mm
治具の作成に使用する装置です。

作成を行った治具の一例
10)鉛フリー対応のPWB表面処理について
メーカーが保証する保管期限は、プリフラックス処理品で未開梱品が2〜3ヶ月、金メッキ・半田レベラ品では
未開梱でかつ 保管条件が良好なら6ヶ月程度といわれています。
1) 耐熱プリフラックス
防錆効果の持続時間が短いため、長期間の保管の必要性がある場合には管理に際して注意が必要です。ただ、
緊急の避難措置として、長期間保管されたものはベーキング処理を施すことで湿気を飛ばして再度フラックスを塗布
して使用可能になる可能性もありますが基板の品質管理の上でも望ましいことではありません。
2) 鉛フリー半田レベラ
垂直レベラと水平レベラの2通りの加工方法があります。ネーミングの通り、吊るして作業をするのが前者、水平に置
いた基板をラインに流して作業するのが後者です。後者は、表面の平滑性が後者より良好です。
ただし、鉛フリー(Sn-3.0Ag-0.5Cu)の場合は半田付け工程を一回行った事になりパターンの銅食われに対する半田
付け履歴管理に注意が必要となります。
3).金めっき
大きく分けて電解めっきと無電解めっき(化学めっき)に分類されます。めっきの工程は、まず表面を弱アルカリ性溶
剤で脱脂したあと、下地のニッケルめっき(1〜3μm程度)を付けて金めっきを施します。金の厚さは、電解めっきでは
0.1μm程度、無電解めっきでは0.01〜0.05μm程度の薄さになります。
11)金フラッシュめっき基板についての問題点
無電解Ni-P/Auめっきと鉛フリー半田の相性について(ブラックパッド)
鉛フリー半田(Sn-3Au-0.5Cu)を実装を行ったとき、半田付けの際にAuが半田に拡散をした後、Ni-Pの表面で半田が
はじかれる。一見正常に見えても,俗に言うブラックパッドを起こしていると発生する現象です。原因として、まずめっき
の質が悪いこと。 金めっきの下地のNiが既に腐食・酸化されている状態で起こるようです.
基板メーカーのNi-Pめっき液の管理が不十分であったり、Ni-Pめっき後の洗浄が不適切な管理の場合、鉛フリー
はんだはSn/Pbはんだに比べ濡れ速度が遅い事もあり、基板の表面状態に影響され、Pが多く残っている場合はんだ
の不濡れが顕著に発生します。
共晶はんだでも生じる事がありますが,めっき液管理のノウハウを持っている事が必要と言われます.
下の写真はSOPリード部のブラックパッド事例です。本事例ではパッドのめっき部を全て除去した後、再度はんだ付けを行い修復いたしました。
拡大
12)鉛フリー対応のBGAを鉛-共晶はんだペーストにて実装時の問題点
鉛フリー化されたBGAを鉛-共晶はんだペーストを使用して実装を行なわなければならない時の注意事項として、
半田付け温度の管理が必要となります。素子側の処理方法によってはバンプの剥離や結合強度の不足が発生する
事があるからです。